논문제목: Indium tin oxide etch characteristics using CxH2x+2(x=1,2,3)/Ar
게재: Materials Science in Semiconductor Processing Volume 160, 15 June 2023, 107395
온라인 link: https://www.sciencedirect.com/science/article/pii/S1369800123000884?via%3Dihub
주요 논의:
1) ITO를 기반으로 한 Dry etching 공정에서 높은 이방성 식각 형태 (profile)과 dimensional 손실 감소를 유도해야함
2) 또한, 공정 이후 chamber wall에 생성되는 잔여물(residue)을 없애기 위한 dry cleaning 방식도 같이 파악해야함
결론:
1) CH4/H2 기반 가스에서의 수소는 etch rate 감소와 selectivity 감소를 유발
2) CxH2x+2 기반 가스를 활용해야 etch rate 와 selectivity의 상승을 유도할 수 있으며, 낮은 dimensional 손실과 좀 더 높은 이방성 프로파일을 구현할 수 있음
3) Dry cleaning의 경우, H2/Ar 기반 플라즈마를 활용하여 성공적인 공정이 가능하였으며, 이러한 공정으로 InCxHy (x < y), COx, SnHx가 생성됨
세부 실험:
H2/(CH4+H2+Ar) 기반으로 실험진행, H2 비율을 전체 유량 대비 조정하면서 PR etch rate와 ITO etch rate 간 비교 진행하였음
H2 비율 상승과정에서 PR etch rate의 선형적인 상승이 있었으나, ITO etch rate의 상승은 거의 미미하여 오히려 selectivity가 하락하는 형태를 띔
추가로, *micromasking effect로 인해 roughness 특성이 더 안좋아진 것에 대해서도 설명함
*micromasking effect: 식각 중 생긴 표면 이물질(또는 부산물)로 인해 국부적으로 식각이 안되고, 그 아래가 기둥형태로 남는 현상
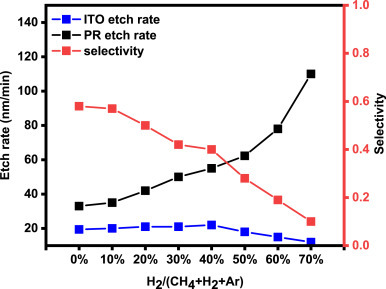
수소(Hydrogen)의 영향을 줄이기 위해 *알케인구조(alkane structure)의 가스 첨가를 진행하여 공정함
*Alkane structure: 탄소(C)와 수소(H)만으로 이루어진 가장 단순한 탄화수소의 구조, 모두 단일결합의 형태로 존재(C-C, C-H)
일정 변곡점에 도달하기 전까지 Ar 비율의 상승에 따라 전반적인 etch rate가 상승하는 형태를 보임
또한, 같은 Ar 비율에서 더 높은 C/H를 지닌 가스 투입 시 더 높은 etch rate와 selectivity를 확인할 수 있었음
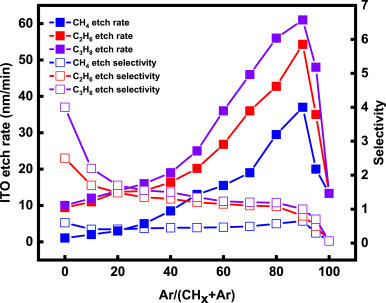
높은 C/H의 가스 이용 시 dimensional loss 및 roughness 개선의 효과도 확인할 수 있었음
아래 SEM 이미지는 Top view로 찍은 이미지인데, CH4에 비해 C3H8이 좌우 간 etched 영역이 더 좁은 걸 확인할 수 있음

또한, 아래 (a) figure의 경우 단면에서 찍은 SEM 이미지인데 profile 형상 측면에서 C3H8이 더 우수한 것을 확인할 수 있음. 이는 논문 앞 단에서 언급한 micromasking effect가 상대적으로 심해 왜곡된 형상을 유발하는 것을 알 수 있음
(b) figure는 위의 이미지와 비슷한 맥락인데, C3H8의 경사폭이 더 좁아 tapered profile 형상이 우수한 것을 확인할 수 있음
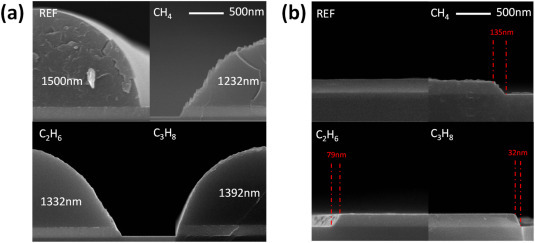
roughness는 *RMS surface roughness 측정 이미지를 확인하면 더 극명하게 보여지는데, CH4에 비해 C3H8이 거의 50% 가량의 차이가 발생함 (0.394nm to 0.273nm)
*RMS는 표면 높이의 표준편차를 계산하여 표기
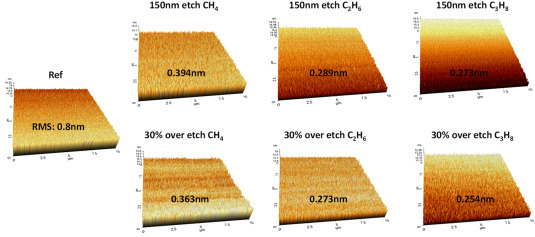

XPS 분석을 통해 아래와 같은 결과를 확인할 수 있는데, CH4에서 Sn의 비율이 낮아지는 이유는 byproduct으로 SnH4를 형성하는 데 SnH4의 경우 boiling point가 -52°C로 매우 높은 volatility를 가지고 있기 때문에 Sn 성분이 휘발되어 아래와 같은 결과가 발생함
또한, Hydrocarbon이 In(CH3)2을 형성하여 In의 감소도 확인할 수 있음

마지막으로 Dry cleaning 과 관련한 분석을 위한 실험으로 process chamber 내의 각 포인트(총 9개소)마다 wafer를 부착하여 실험을 진행함
아래 이미지는 9개의 위치 별 CH4 증착 두께를 보여주고, XPS 분석을 통한 원소별 비율을 나타냄

아래는 Etch mechanism과 Dry clean의 mechanism을 비교할 수 있게 만든 이미지로, Ar과 H2를 활용하여 Dry cleaning이 진행되는 것을 확인 할 수 있음
